Thru-cup® EVF-N Kupfer Via-Fill-Electrolyt
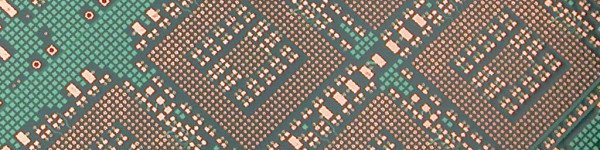
Thru-cup® EVF-N Kupfer Via-Fill-Electrolyt
Additive für sauer Kupfer-via-filling
Thru-cup® EVF-N ist ein neues Additivsystem für die elektrolytische Kupferbeschichtung von Leiterplatten. Es wird im Panel- und im Pattern-Plating von Sacklöchern und gleichzeitigem Durchkontaktieren von Bohrungen eingesetzt. Die Füllgrade der Sacklochbohrungen mit Durchmessern unter 150 μm sind hervorragend. Thru-Cup® EVF-N arbeitet mit drei Additiven, die einfach über CVS analysiert werden können. Die Charakteristik des Füllgrads wird durch die Elektrolytalterung nicht beeinflusst. Die abgeschiedene Kupferschicht weist eine ausgezeichnete Dickenverteilung auf.
Anwendungsmerkmale
- Verbesserung des Wärmemanagements
- Für HDI-Leiterplatten
- Langfristige Zuverlässigkeit der Bestückungs- und Packagingverfahren

Vorteile
- Hervorragende Fülleigenschaften von Sacklochbohrungen
- Geeignet für das Panel- und Pattern-Plating bei gleichzeitiger Durchkontaktierung von Bohrungen
- Lange Elektrolytlebensdauer
- Hervorragende Dickenverteilung der plattierten Kupferschicht
- Die Konzentrationen aller Additive können mittels Zyklovoltammetrie (CVS) analysiert werden
Anwendungen
- IT-Produkte
- Unterhaltungselektronik
- Automobilanwendungen
Benötigte Additive und optionale Produkte
- EVF-2A-10X
- EVF-2B-2X
- EVF-N
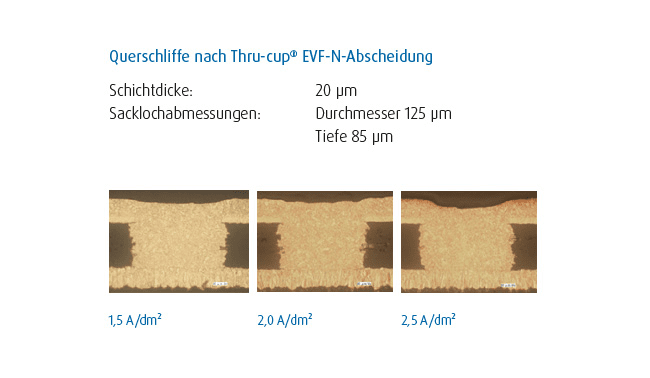

Ihr Ansprechpartner
